IC封装基板发展趋势
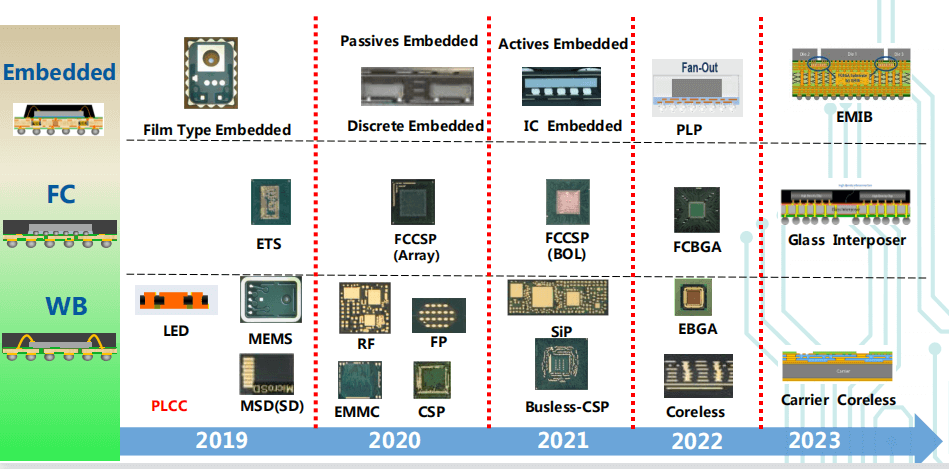
常规四层IC载板压合结构
4层IC载板板厚度0.22mm | |||||
AU | 0.03-0.05um | ||||
Ni | 3-8um | ||||
CU | CU7um+电镀8um | 15um | |||
压合BTPP | 50um | 350um | |||
CU | CU7um+电镀8um | 15um | |||
BT | 50um | 50um | |||
CU | CU7um+电镀8um | 15um | |||
压合BTPP | 50um | 50um | |||
CU | CU7um+电镀8um | 15um | |||
Ni | 3-8um | ||||
AU | 0.03-0.05um | ||||
总厚度 | 220um±30um | ||||
6层IC载板板厚度0.35mm | |||||
AU | 0.03-0.05um | ||||
Ni | 3-8um | ||||
CU | CU7um+电镀8um | 15um | |||
压合BTPP | 50um | 50um | |||
CU | CU7um+电镀8um | 15um | |||
压合BTPP | 50um | 50um | |||
CU | CU7um+电镀8um | 15um | |||
BT | 50um | 50um | |||
CU | CU7um+电镀8um | 15um | |||
压合BTPP | 50um | 50um | |||
CU | CU7um+电镀8um | 15um | |||
压合BTPP | 50um | 50um | |||
CU | CU7um+电镀8um | 15um | |||
Ni | 3-8um | ||||
AU | 0.03-0.05um | ||||
总厚度 | 350um±30um | ||||
后续逐步研发6层以上IC封装基板。
三菱材料特性MITSUBISH | |||||
Grade材料登记 | CCL Thickness材料厚度 | BT Prepregs 树脂类型 | Prepreg Thickness | property特性 | Typical applications典型应用 |
HL832NX type A | 0.03, 0.04, 0.05, 0.06, 0.1, 0.15, 0.2, 0.25, 0.3, 0.35, 0.4, 0.45, 0.5, 0.6, 0.7, 0.8 | GHPL-830NX | 0.02 ~ 0.1 | low CTE, low shrinkage, and high Tg | CSP, BGA, Flip Chip Package, Coreless, SiP, Module, etc. |
CCL-832NSR | 0.03,0.04,0.05,0.06,0.1,0.15,0.2,0.25,0.3,0.4 | GHPL-830NSR | 0.02 ~ 0.045 | Low CTE and low shrinkage | Coreless, SiP, Module, CSP, BGA, Flip Chip Package, etc. |
CCL-HL832NSR | 0.03, 0.04, 0.05, 0.06, 0.1, 0.15, 0.2, 0.25, 0.3, 0.4 | GHPL-830NSR | 0.02 ~ 0.08 | Low CTE and low shrinkage | Coreless, SiP, Module, CSP, BGA, Flip Chip Package, etc. |
CCL-832NSF | |||||